这几年,因为三星在芯片代工上的拉垮,台积电是赚的盆满钵满。
数据显示,目前3nm芯片,台积电包揽了全球的95%,三星只占了5%左右的份额。
而在7nm及以下的市场,台积电包揽了85%以上,三星大约可能只有10%左右,想当年在14nmFinFET技术时,三星与台积电,是平分秋色的。

当时苹果、高通的先进芯片订单,都要分出一部分给三星,不让台积电一家独大的。但到了如今三星早已没有了与台积电PK的能力了。
为何会这样,一方面是三星的芯片良率太低了,低到令人发指,这样芯片制造效率低,成本高,让苹果、高通都受不了。
其次就是三星的工艺不太行,晶体管密度低,同时功耗控制不佳,发热严重,所以苹果先放弃了三星,后来高通也放弃了三星,彻底转向了台积电。
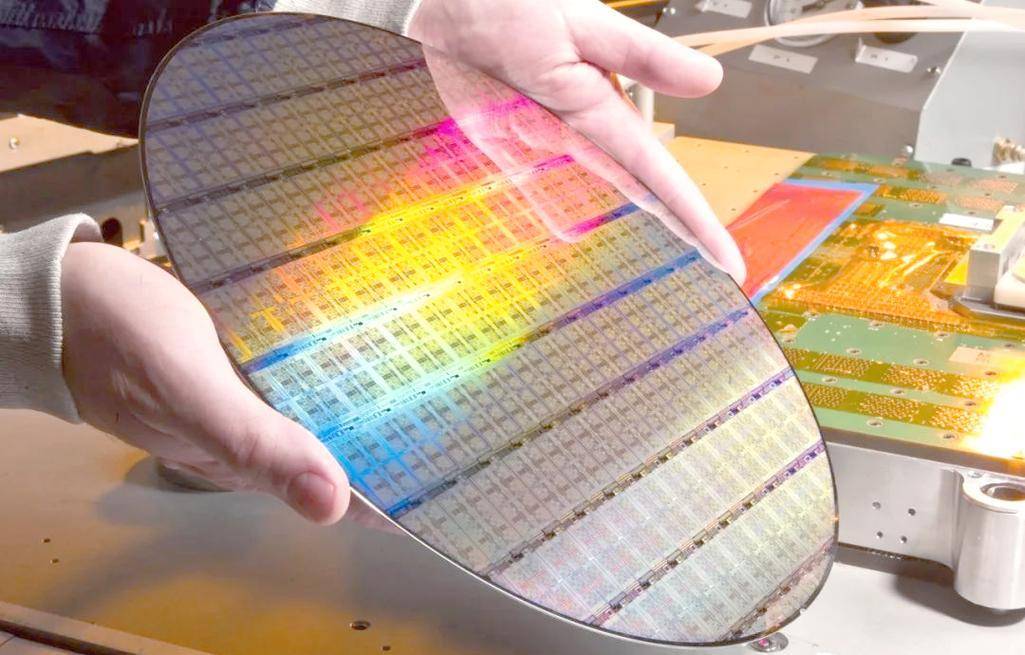
为此,三星这几年是只想翻身,全球第一个量产3nm技术,全球第一家采用GAAFET晶体管技术等,但这些努力,都没让自己好转起来,良率、功耗、性能依然是三星缺点。
不过近日,有消息称,三星在芯片制造上,可能搞出了一个“黑科技”,这个黑科技可以让高通、苹果的手机芯片降温30%,目前三星正向高通、苹果等客户推荐这个技术,如果让三星代工,三星就会向他们开放这个技术。
这个黑科技,到底是什么黑科技,是一种被称之为“HPB”的技术.

“HPB”是一种叫做“Heat Pass Block”的全新的封装技术,其原理是在封装时,在Soc内,让一个铜基 HPB 散热器,直接与处理器核心直接接触,这样让芯片内核一有热量,就能够直接传导散发出来,提升热传导效率,达到快速散热,然后降温的效果。
据称,这种封装方式,可以让芯片平均降温30%,这样在手机中更能够发挥出手机芯片的性能,而不会因为太热而降温。
同时放在手机中时,这种Soc的散热方式也就更好处理和灵活了。

三星计划是通过这个技术,来吸引苹果、高通等客户找自己下单,同时为了让客户相信自己,三星计划在Exynos2600中使用这个技术,证明给外部客户看。
所以接下来就要看三星的这个Exynos2600芯片,有没有他说的这么神奇了,如果真的这种黑科技能够让手机芯片温度降30%,那台积电就真的要慌了。
因为芯片越先进,发热越大,功耗控制越难,苹果、高通等正在找办法了,如果三星有,那肯定就找上三星了,那台积电的订单就会流量非常严重,这是台积电不愿意看到的。